RFスパッタとは
RFスパッタとはRF(Radio Frequency)と呼ばれる高周波帯の電源を用いたスパッタ方法です。DCスパッタでは行えない絶縁性ターゲットのスパッタ電源としてよく利用されます。
色々なターゲットをスパッタ可能ですが、導入にはRFマッチングユニット等が必要になるため、DCスパッタ源と比較して高額になる傾向にあります。このページではRFスパッタに関する原理の理解と基礎知識について学べるように解説を行います。
RFスパッタの原理と絶縁性ターゲット
DCスパッタではターゲットにマイナスのDC電圧をかけることで、プラスイオンを引き込みスパッタ現象を発生させます。ですが絶縁性ターゲットの場合は導電性がありませんので、引き込んだイオンの電荷によりターゲット表面が瞬時にチャージアップされ次のイオンを引き込めなくなります。
対してRFは周波数を持つ交流電源のため、ターゲットにかかる電圧はプラスとマイナスが交互に入れ代わります。そのためプラスイオンとマイナスの電荷を持つ電子をどちらも引き込むことができ、チャージアップを起こさず絶縁性ターゲットを継続的にスパッタすることが可能となります。
絶縁性ターゲットとバッキングプレート
絶縁性ターゲットは強度的に脆いものが多く、スパッタ成膜をしていると熱応力により割れてしまうことが多々あります。そのため絶縁性ターゲットを使用する時はバッキングプレートと呼ばれる銅製のプレート上にインジウム等で絶縁性ターゲットをボンディングしてスパッタ放電することが一般的です。これは、割れそのものを防ぐためではなく、割れたターゲットがバラバラになることを防止するものです。バッキングプレートにボンディングしていればターゲットが割れたとしてもその形を保っていられますので、そのまま継続して使用することが可能です。
RFマッチング
RFスパッタは使用するターゲットやレシピに応じてマッチングユニットの調整が必要になる場合があります。これはDCスパッタには必要のない準備のひとつです。
通常はマッチングユニットの中にあるバリアブルコンデンサを外部から動かすことで反射波を相殺し、放電領域を設定していきます。ですがそれだけでは安定して放電を起こせない場合もあり、その時はマッチングユニットを開けて内部の調整を行います。マッチングユニット内部にはバリアブルコンデンサのほかに固定のコンデンサとコイルが備わっており、この固定コンデンサを外す(あるいは付ける)ことで調整を行います。またコイルにはターンごとにねじ穴が切られており、どのねじ穴に配線するかによってターン数を変えられるようになっています。ここでコイル長を変更することで調整をする場合もあります。
またマッチング領域はちょっとしたことで変動してしまいます。放電しない、マッチングが取れないといったときにはマッチングユニットの調整ももちろん必要ですが、スパッタ時の真空度、電極部のシールド形状、アース線のとりかた、同軸ケーブルの取りまわしなどを見直すことで改善することもあります。
RFイグニッション(着火)
RFスパッタはDCスパッタと比べてプラズマの着火がしにくい傾向にあります。これは前述のマッチングが要因の一つでもありますが、放電時にマッチング調整が出来ている場合でも起こります。こういった時には着火トリガーとしてスパッタカソードにDC電圧を印可したり、一時的にプロセスガス流量を増やして真空度を悪くすることで着火させるなどの工夫が必要になります。スパッタ放電は真空度が悪い(チャンバー圧力が高い)領域のほうが着火しやすいためです。ですが真空度が悪い状態で成膜を行うと、薄膜表面がでこぼこになったりレートが下がったりといった問題が起こるので、着火時にだけ真空度を悪化させて、その後は放電させたまま目標の真空度まで圧力を落としていくといった使い方をします。
スパッタレート
スパッタレートとはスパッタ放電にて薄膜を形成していく速度のことを言います。単位はÅ/sec(オングストロームパーセコンド)あるいはnm/sec(ナノメートルパーセコンド)で表現します。
RFスパッタはDCスパッタと比べると同じ電力を出力してもスパッタレートが低くなってしまいます。これはRFが交流電源のためどうしても効率面で直流電源に劣ってしまうためです。とはいえ極端にスパッタレートが下がるわけではありませんのであまり心配はいりません。またスパッタレートはT/S間(ターゲット~基板間距離)を調整することでも上げ下げが可能です。
補足 T/S間距離
前述のようにT/S間距離はスパッタレートに影響します。T/S間を短くすることでスパッタレートは早くなり、逆にT/S間を長くすることでスパッタレートは遅くなります。ですがスパッタレートを早めるためにT/S間を短くすると、その分成膜した膜厚分布は悪くなってしまいます。特に基板の面積が大きくなるほどこの傾向が強くなるので注意が必要です。
それ以外でもT/S間を短くすることでプラズマによる基板へのダメージが発生することもあったり、逆にT/S間を長くすることで窒化物などの反応性ターゲットから窒素が抜けてしまい思うように薄膜を形成できないこともあります。スパッタ装置を使用する中で目的に応じて適切なT/S間距離を模索することも大切なことと言えます。
必要設備
DCスパッタを利用するときにはDC電源さえあれば大丈夫ですが、RFスパッタではこれまで述べた通り専用のRFジェネレータのほかにマッチングユニットも必要になります。そのためDCスパッタと比べて導入にはかなり多くの費用が必要になります。またマッチングユニットにも内部のバリアブルコンデンサを手動で操作するタイプと、RF出力をフィードバックしながら自動調整を行うオートマッチングタイプとがあり、後者のものはより高額になります。
また、それだけでなくRF電源を使用する場合は、高周波設備利用申請を行い許可を得る必要もあるため、RFスパッタ導入にはそれなりの費用と手間がかかることになります。
このようにコストや使い勝手の面でDCスパッタに劣る部分はありますが、多様なターゲットを使用できるというRFスパッタの利点はとても大きく、多くの現場で利用されています。
RFスパッタ同時放電
目的の薄膜を得るために複数のRFスパッタを同時放電させたいときもあると思います。この時注意したいのが周波数の相互干渉です。RFは13.56MHzの周波数を発振しますが、複数のスパッタ源がこの周波数を発振することで相互干渉し、計器や放電に異常をきたすことがあります。RFジェネレータの上位機種にはこれらの対策として周波数をわずかに可変させ、相互干渉を防ぐ機能をもったものもあります。同時放電を検討しているときはこれらのことにも留意してみてください。
スパッタ源が放電しなくなったとき
いつも通り使えていたスパッタ装置がある日突然スパッタ放電しなくなったり、異常放電を起こすようになったりしたことはありませんか?もしかしたらスパッタ源の汚れが原因かもしれません。
スパッタ源はアースシールドとカソードのクリアランスが非常にシビアに設計されています。そのため試料のフレークがシールド上に溜まってきてカソードとの関係が変化してくると突発的な異常放電などが発生しやすくなります。成膜装置はその特性上使えば使うほど汚れていきますので、長く安全に使うためにも、こまめな清掃とメンテナンスをお勧めします。
また成膜用スパッタ源はターゲット部に磁石を内蔵したマグネトロンタイプが主流となりますが、長く使っていると磁石の磁力が減磁していきます。この磁力が一定の閾値以下になると、スパッタ源は放電しなくなってしまいます。
磁石は熱による減磁も起こりますので、高出力で長時間の放電を行うと新品のスパッタ源でも磁力がなくなってしまうこともあり得ます。こういったことを起こさないようにスパッタ源の冷却性能を把握しておくことも大事なことです。
スパッタ放電しているのに成膜レートが出ないとき
スパッタ成膜をしていると、プラズマが放電しているのにスパッタレートが出ない・成膜が進まないといったことが稀に起こります。これらはターゲット表面の酸化や、チャンバーの残留ガスによる影響が考えられます。
例えばアルミニウムや鉄といった酸化しやすいターゲットは、大気中で保管しておくとターゲット表面の酸化が進んでしまい、これらをスパッタしても放電しているのにレートがでないということが起こります。その時はターゲット表面の酸化膜がなくなりレートがでるようになるまでRFでプレスパッタし、クリーニングすると良いでしょう。
また窒化物などの絶縁性ターゲットは導体ターゲットに比べて非常にスパッタレートが低くなります。ですので成膜前のチャンバーの排気が少ないと残留ガスが多くなり、スパッタ放電させているのにスパッタレートが出ないといったことが稀に起こります。そうさせないためにも絶縁性ターゲットを成膜するときは十分にチャンバーを排気してから行うように留意すると良いと思います。
ICP(誘導結合プラズマ)放電
通常の成膜用のマグネトロンスパッタはCCP(容量結合プラズマ)方式となっていますが、クリーニングや活性反応を目的としたICP(誘導結合プラズマ)放電のコンポーネントもあります。これは真空中のコイルにRFを印可し、コイルの内側を流れるガスをイオン化、あるいはラジカル化させて基板に放出するというものです。
クリーニング(エッチング)を目的とする場合はArなどの希ガスを流し、イオン化させて基板に放出することで、基板表面のスパッタを促します。
また窒素や酸素を流しRFによりラジカル化させ基板に放出することで基板の窒化・酸化反応を促すこともできます。
このコンポーネントは単一に使うだけでなく、分子線エピタキシー装置などと組み合わせて、Kセルで成膜を行いながらラジカルを放出し活性反応を促すという使い方も可能です。(RF-MBEと言います)
真空デバイスのRFスパッタ装置とRFコンポーネント
RFスパッタ装置 【VRF-100S】
RF電源を搭載した高周波スパッタ装置です。酸化膜、絶縁膜の成膜、多層膜の作成(5源)が可能です。
真空デバイスのRFスパッタ装置VRF-100Sは、切り替え方式による5連装ターゲットを標準搭載しております。
RFコンポーネンツ 【VMCシリーズ】
組み込み型のRFコンポーネンツを各種ラインナップしております。
1インチ、2インチ、また磁性材対応の強マグネットタイプがございます。
オプションで、シャッター機構、ガス導入機構、DC電源を投入することも可能です。
特注品の例
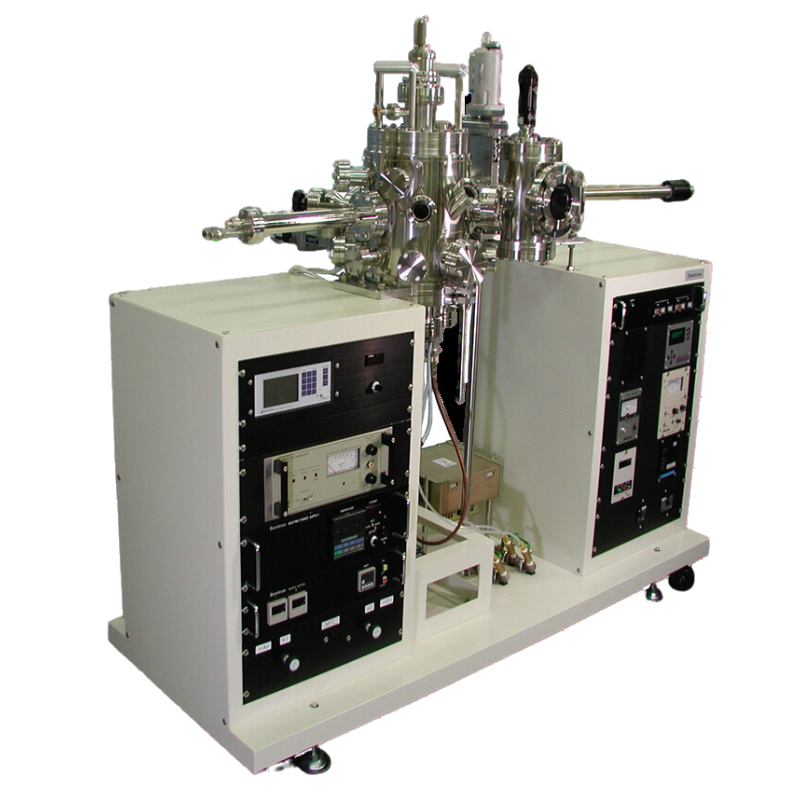
【RFスパッタガンを取り付けた特注例】
特注品のチャンバーにRFコンポーネントを接続した一例です。
このように、既存の装置に導入用のICFサービスポートがあれば後付けでRFコンポーネントを取り付けることも可能となります。








